设备
PMI(Probe Mark Inspection) 设备 KWI-300
MI探针标记检测系统简介
该设备用于检测晶圆PAD上的探针痕迹(Probe Mark)的尺寸与位置,以评估探针卡(Probe Card)的接触性能。
与传统的抽样检查或目视检查不同,该系统可在短时间内检测整片晶圆上所有PAD,从而分析接触痕迹的分布模式与趋势。
此外,通过分析PMI数据,有助于提升探针卡的整体品质。
通过分析**接触擦痕(Contact Scrub Mark)**的长度,可判断测试后针尖是否发生断裂或损伤。
检测结果可导出为CSV文件,并可整理为报告形式提交给客户。
PMI(探针痕迹检测)设备规格
| 测量时间(12英寸 / 10,000针) | ≤ 15分钟(中等使用条件)
※ 取决于PAD的形状与位置,PMI时间可能有所不同 |
| 测量方式 | Area Confocal(区域共焦)方式 |
- 支持8英寸和12英寸晶圆
- 搭载高速 / 高精度平台与稳定控制技术
- 操作简便,可自动生成PMI检测结果数据
- 检测完成后仍可基于PMI数据进行二次分析及Fail数据重检
- 支持对空晶圆(Blank Wafer)进行PMI检测
- 可配置客户定制选项(如1端口/2端口LPM、FFU、晶圆表面检测模块等)
- 支持多种倍率镜头组合(1X*、2X、5X、10X、20X)
- 提供数据备份功能(硬盘镜像)
- 可自动移动至指定PAD位置进行检测
放大倍率及视野范围(FOV:视场)
| 放大倍率 | 1X(可选) | 2X | 5X | 10X | 20X |
|---|
| 视野范围 (mm) | 8.0 × 6.0 | 4.0 × 3.0 | 1.6 × 1.2 | 0.8 × 0.6 | 0.4 × 0.3 |
设备设定类型
| 设备设定 [类型 1]
通过 Live Vision 提供晶圆图(Wafer Map)
设置测试 / 未测试芯粒(Die)
生成 PAD 数据
📌【生成晶圆图】 | 设备设定 [类型 2]
加载探针卡数据(Probe Card Data)
不生成晶圆图或 PAD 数据
📌【根据探针卡数据生成晶圆图】 |
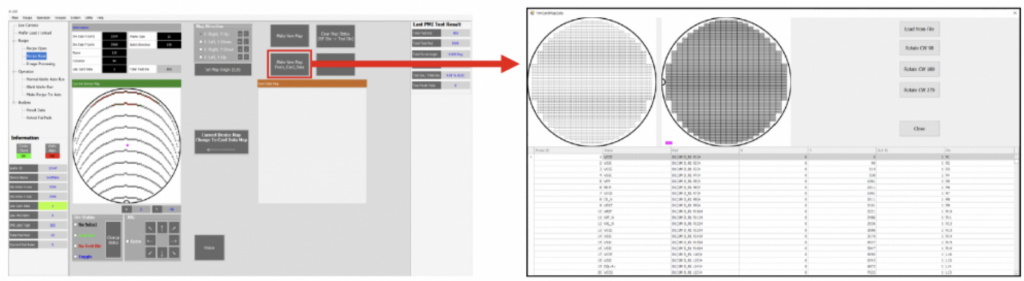
本说明对比了两种设备设定方式(类型1与类型2)。
类型1是通过用户操作手动创建晶圆图(Wafer Map)并收集PAD信息的方式,
而类型2则是基于探针卡中预存的数据自动生成晶圆图的方式。
复检功能
支持对全部失败结果或指定PAD进行在线复检。
可通过比对历史检测数据与实际晶圆,实现复检操作。
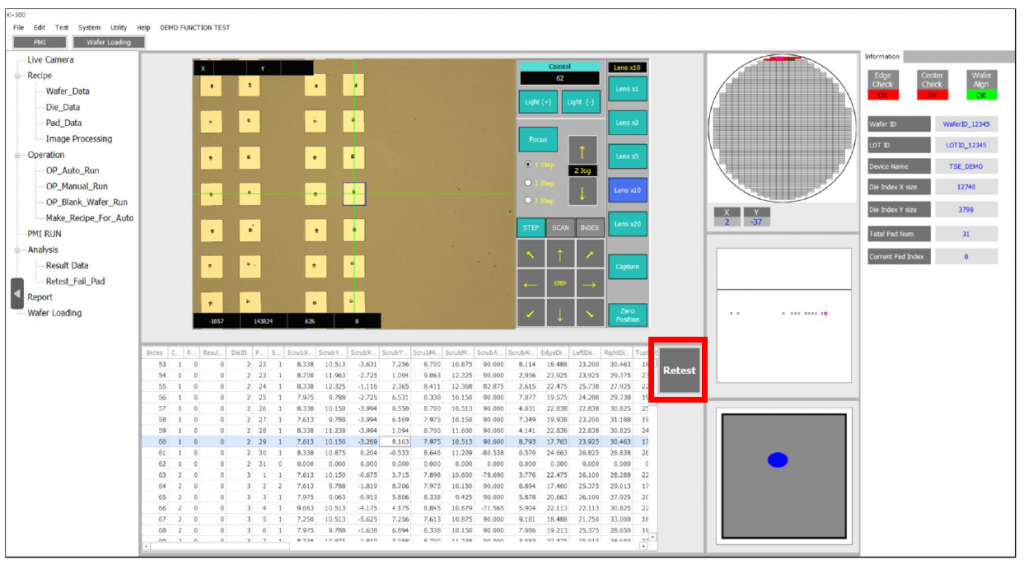
数据表 / 重测功能
PMI结果数据(20种)的输出与汇总
支持对全部或选定的Pad进行Fail结果的在线重测
可调用现有测试数据,与实际晶圆进行比对并执行重测
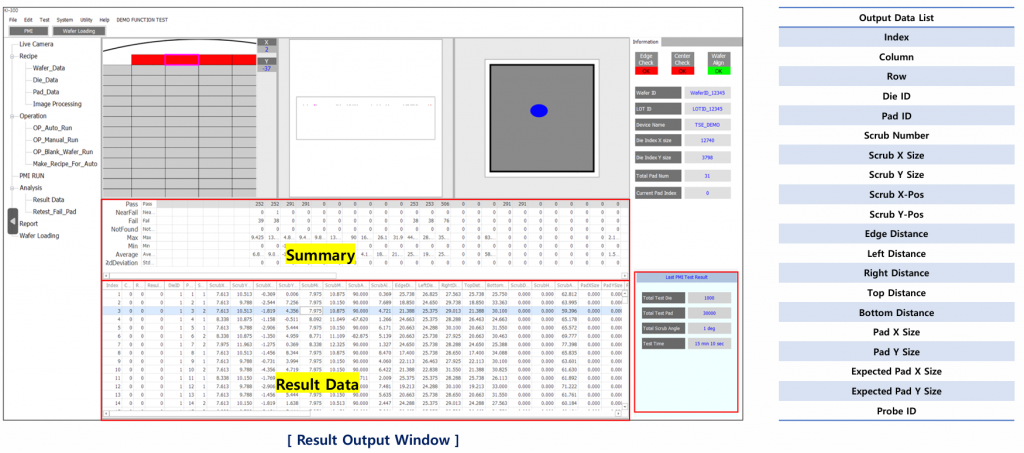
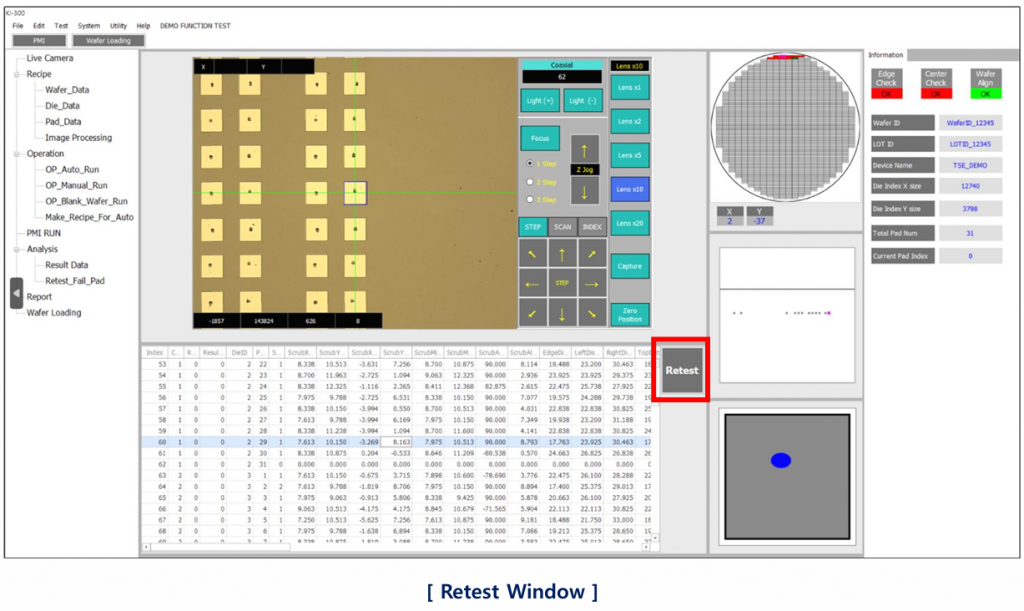
放大倍率
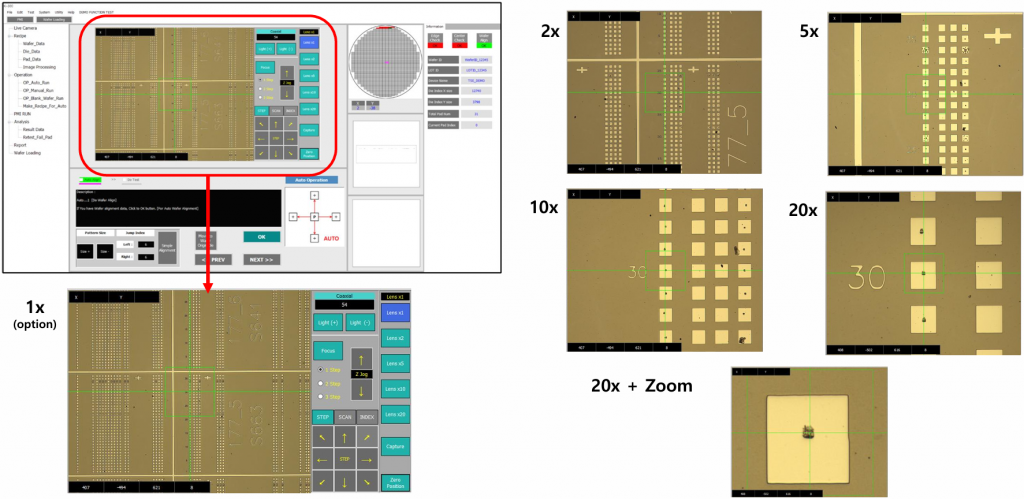
PAD位置和形状对应的PMI测试时间
- Wafer Size : 12inch Wafer
- Probe Card Type : Memory Probe Card