장비
PMI(Probe Mark Inspection) 장비 KWI-300

MI 검사 시스템 개요 (Probe Mark Inspection)
이 장비는 웨이퍼 PAD 위에 형성된 Probe Mark의 크기 및 위치를 검사하여 Probe Card의 콘택트 특성을 평가합니다.
기존의 샘플 검사나 육안 검사와 달리, 웨이퍼 전체의 모든 PAD를 짧은 시간 안에 검사하여 콘택트 마크의 패턴과 경향을 파악할 수 있습니다.
나아가, PMI 데이터를 분석함으로써 Probe Card의 품질 향상에 기여할 수 있습니다.
**콘택트 스크럽 마크(Contact Scrub Mark)**의 길이를 분석하여, 테스트 후 니들 팁의 파손 여부를 확인할 수 있습니다.
검사 결과는 CSV 파일 형식으로 출력 가능하며, 고객사에 결과 보고서로 제출할 수 있습니다
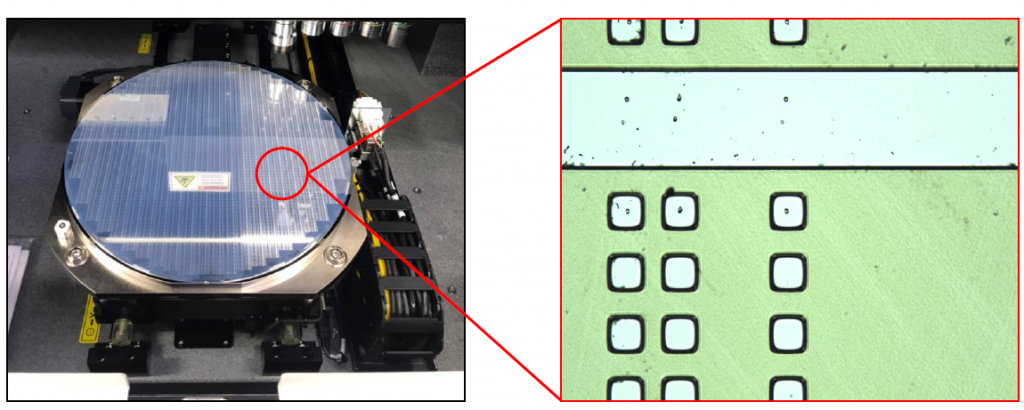
PMI(Probe Mark Inspection) 장비사양
| 항목 | 사양 |
|---|
| 장비명 | WI-300 (구 KI-300) |
| 측정 시간 (12인치 / 10,000핀 기준) | ≤ 15분 (중간 사용 기준) ※ PAD의 형상 및 위치에 따라 PMI 시간이 달라질 수 있음 |
| 측정 방식 | Area Confocal 방식 |
| 정밀도 | 픽셀 크기: 1 μm, 해상도: ≤ 1 μm |
| 조명 | 표준 조명 |
| 고속 포커스 | 지원됨 |
| 장비 간 오차 보정 | 지원됨 |
| 실시간 이미지 캡처 | 지원됨 (흑백) |
| 전체 웨이퍼 컬러 이미지 캡처 | 지원됨 (컬러) |
| 렌즈 터렛 구성 | 4단 자동 회전식 터렛 |
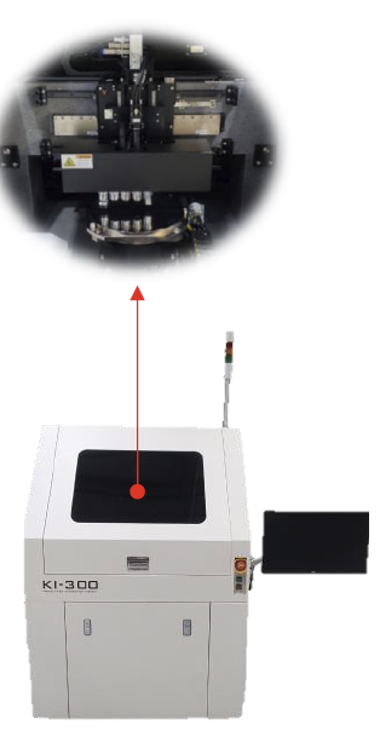
- 8인치 및 12인치 웨이퍼 대응 가능
- 고속/고정밀 스테이지 및 안정화 기술 탑재
- 조작이 간편하며 PMI 결과 데이터를 자동 생성 가능
- 검사 완료 후에도 PMI 데이터를 기반으로 추가 분석 및 Fail Data 재검사 가능
- Blank Wafer에 대한 PMI 검사도 가능
- 고객 맞춤형 옵션 장착 가능 (1포트/2포트 LPM, FFU, 웨이퍼 표면 검사 모듈 등)
- 다양한 배율 렌즈 조합 지원 (1X*, 2X, 5X, 10X, 20X)
- 데이터 백업 기능 제공 (하드디스크 미러링)
- 지정된 PAD 위치로의 자동 이동 가능
배율 및 시야각 (FOV):
| 배율 | 1X (옵션) | 2X | 5X | 10X | 20X |
|---|---|---|---|---|---|
| 시야각(mm) | 8.0 × 6.0 | 4.0 × 3.0 | 1.6 × 1.2 | 0.8 × 0.6 | 0.4 × 0.3 |
장비 설정 타입
| 디바이스 설정 [Type 1] Live Vision을 통해 제공되는 Wafer Map 테스트 / 미테스트 다이 설정 PAD 데이터 생성 📌 [Wafer Map 생성] | ※ 디바이스 설정 [Type 2] Probe Card Data 로딩 Wafer Map 및 Pad Data 미생성 📌 [Card Data로부터 Wafer Map 생성] |
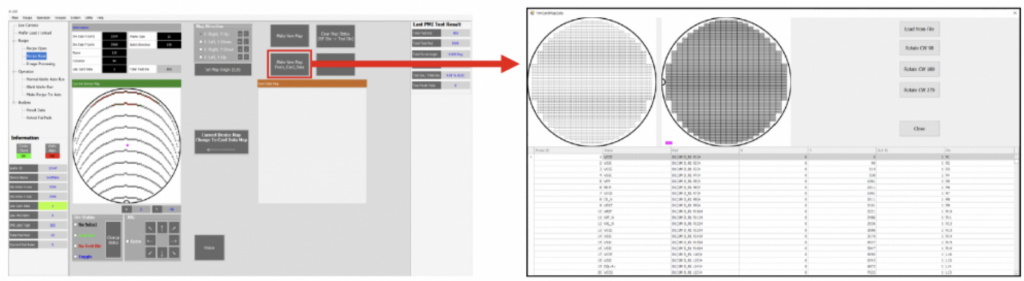
이 설명은 두 가지 방식의 디바이스 설정 방식(Type 1, Type 2)을 비교한 것으로,
Type 1은 직접 Wafer Map을 만들고 Pad 정보를 수집하는 방식이며,
Type 2는 Probe Card에 저장된 데이터를 기반으로 Wafer Map을 자동으로 생성하는 방식입니다.
재검사 기능
전체 Fail 결과 또는 선택된 PAD에 대한 온라인 재테스트 가능
이전 검사 결과와 실제 웨이퍼를 비교하며 재검사 수행 가능
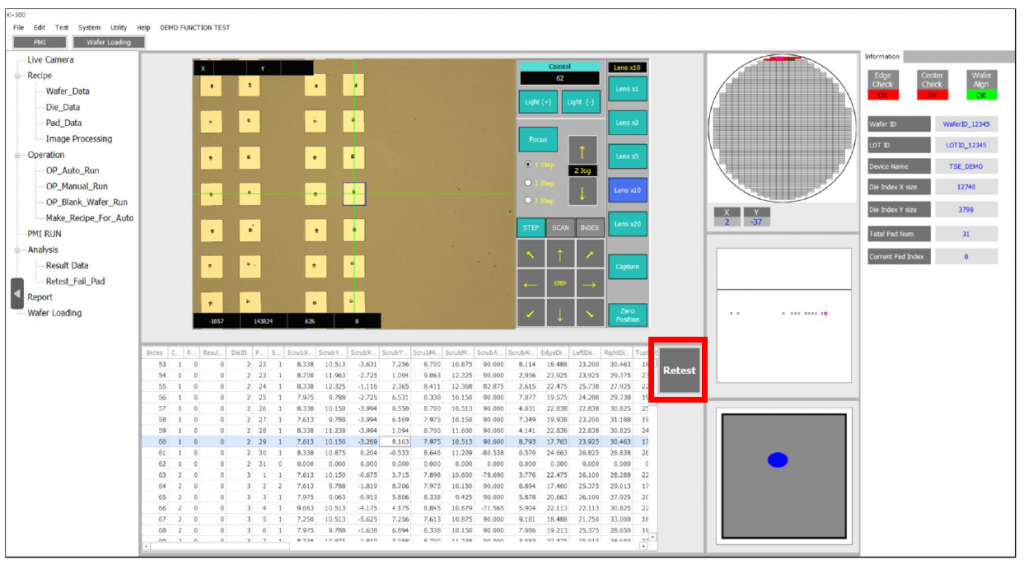
DATA 시트 / Retest 기능
PMI 결과 데이터 (20종) 출력 및 요약
Fail 결과 전체 또는 선택된 Pad에 대한 Online Retest 가능
기존 결과 Data들을 불러오고, 실제 Wafer와 비교 및 Retest 가
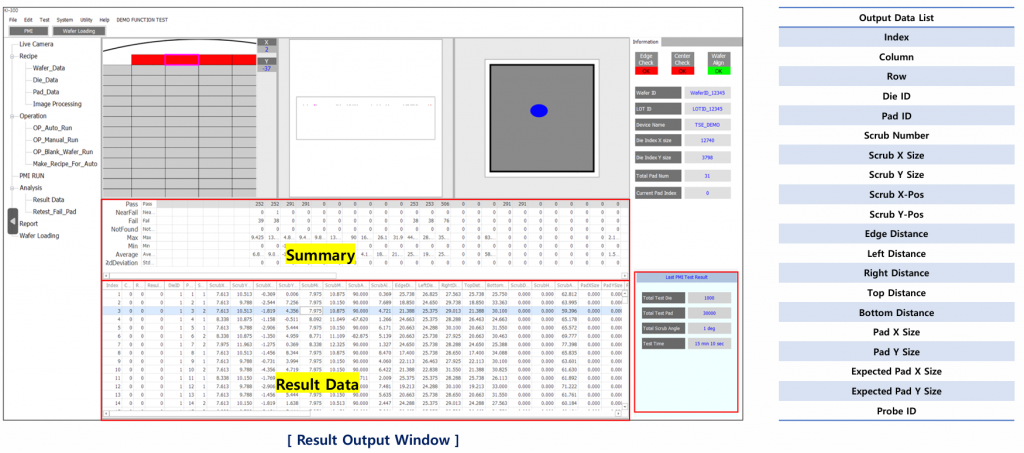
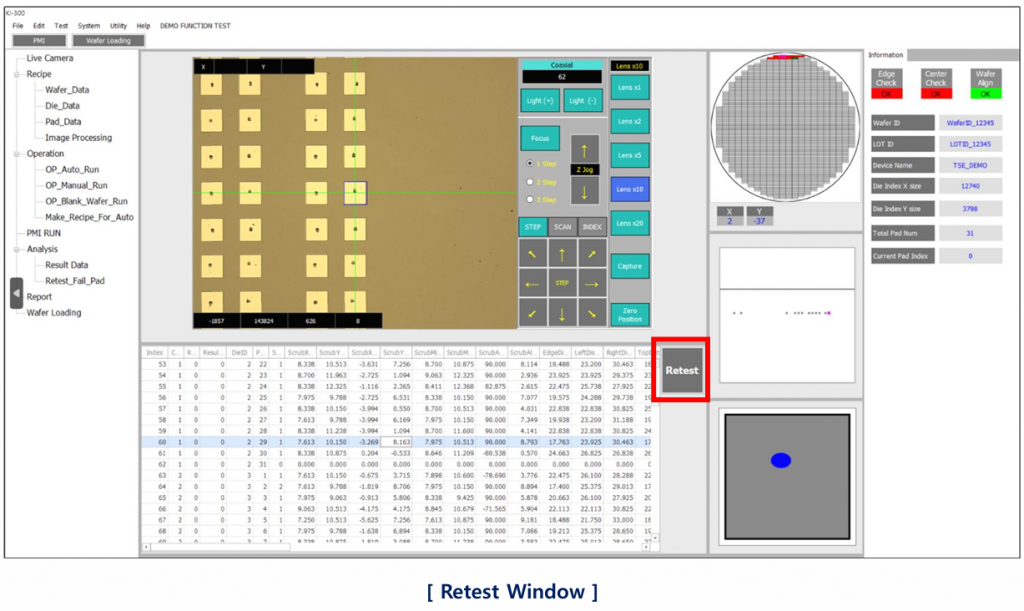
확대 배율
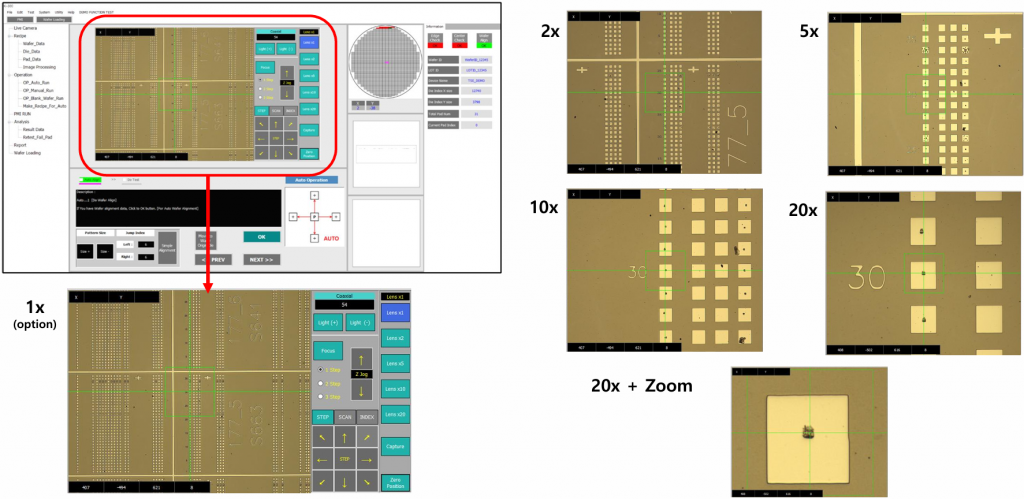
PAD 위치 및 형상에 따른 PMI 시간
- Wafer Size : 12inch Wafer
- Probe Card Type : Memory Probe Card